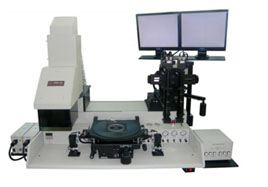
|
中文名称: |
双面对准曝光机 |
英文名称: |
Back Side Visible Mask Aligner System |
仪器编号: |
01522156 |
仪器型号: |
ABM/6/350/NUV/DCCD/BSV/M |
生产厂家: |
美国ABM,Inc |
放置位置: |
柔性电子制造实验室 |
功能介绍
可以实现各种非标准基片曝光、复杂微纳图案、正反双面曝光、制备微电子器件、多层硅通孔器件、柔性电子器件、MEMS器件。
主要技术参数
·350W近紫外光源(365nm/405nm/436nm),具有恒定光强与恒定功率两种控制模式可调节。
·均匀光束面积不小于6英寸。
·光强均匀性:<±1% 直径 2”区域;<±2% 直径 4”区域;<±3% 直径 6”区域
·输出强度:365 nm光强输出强度>20mW/cm2;或400 nm光强输出强度>40mW/cm2
·光学系统具抗反射涂层以及消除衍射效应的功能。
·设备本身具有365nm线与400nm线光强探测功能以及反馈调节功能。
·光束发散半角不大于2°
·具有安全报警和自我保护功能。
·具有三种曝光模式:硬接触,软接触,间隙式。
·支持正胶,负胶SU8等厚胶工艺
·在一微米厚度的正胶条件下线宽制备能力:<0.5μm ——硬接触; <0.8μm——软接触;<1μm——间隔50微米; <2μm——间隔100微米
·正面对准精度优于±1.0μm,背面对准精度优于±2.0μm
·采用双CCD对位系统,图像放大倍率在100倍-850倍范围内连续可调。
·能完成最小到15mm晶圆双目双视场的同时对准。
·通过更换夹具能完成4-6英寸晶圆的光刻。
·系统应具备电控和启动的控制操作面板。
应用图例
应用于半导体光刻工艺制程、光波导、光栅、微机电MEMS、LD、二极管芯片、发光二极体(LED)芯片制造、显示面板LCD、光电器件、纳米压印以及电子封装等诸多领域。